雷尼紹:先進位置編碼器技術(shù)提升光刻(kè)工藝水平
2019-6-20 來源:雷尼(ní)紹(shào) 作者:-
光(guāng)刻技術,顧名思義就是(shì)一種用光刻印的技術,它廣泛(fàn)應用於半導體製造(zào)行業以及許多其他納米技術應用(yòng)中(zhōng);為適應當今微電子產品日趨(qū)微型(xíng)化的趨勢,相關應用(yòng)領域越來越需要具備高生產能力(lì)的光刻設備。
本文探討了位(wèi)置反饋技術在現代光刻工(gōng)藝(yì)中的應用,以及最新光柵(shān)係統和傳統激光尺係統各自的優勢與潛能,這些特性為機器設計人員提(tí)供了極大的靈活性,使其能夠探索如何在不影響性能的前提下最大程度地減少光刻設備(bèi)的占地麵積。
半導體製造
在光刻工藝中,通(tōng)常首先在矽晶圓上沉(chén)積一層(céng)光敏性光(guāng)致抗蝕劑材料(光刻膠)。然後,光束通過光掩模(mó)照射到晶圓上,以將掩模圖形呈現在光刻(kè)膠上,再使(shǐ)用顯(xiǎn)影劑溶(róng)解掉經過曝光的光刻膠區域。最後,選擇性地在晶圓表麵上的(de)裸露區域內進行蝕刻或填充半導體、導電或絕緣(yuán)材料。通過這種(zhǒng)方式,便可構建出所需的多個微電子特征層(通常要進(jìn)行大約30次光(guāng)刻流程)(參見圖1)。
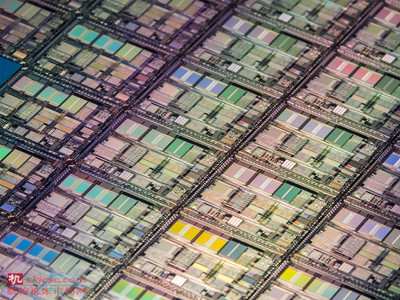
圖1:顯微鏡(jìng)下的矽晶圓
浸沒式掃描(miáo)光刻機包含一套透鏡係統,用於使光束穿過光掩模或“中間掩模”聚(jù)焦(jiāo)到(dào)半導體晶圓(yuán)上。它還含有一組密封元件(jiàn),可在物鏡和半導體襯底(dǐ)之間(jiān)封(fēng)入一定(dìng)體積的液體,由於液體的光線折(shé)射率高於空氣,因此(cǐ)可以獲得更高的光學(xué)分辨率和更小的特征(zhēng)尺寸。
在浸沒掃描中,光束保持固定(dìng),而由(yóu)於透鏡的倒(dǎo)置效應,光掩模和晶圓需沿(yán)相反方(fāng)向運動。這需要將位置(zhì)精確反饋到(dào)光掩模和晶圓運動平台上的控製致(zhì)動(dòng)器,以實現高精度的運動控製(zhì)。可使光源以一(yī)定頻率閃爍,以便每次曝光晶圓上的不同區域。
光掩模與晶圓襯底精確對準,使(shǐ)得每(měi)片掩模上(shàng)的圖案均可精確(què)刻(kè)畫到已經存(cún)在的蝕刻圖形層上。這一步驟是製造集(jí)成電路 (IC) 的關鍵:晶圓(yuán)和光掩模上的基準點自(zì)動(dòng)對準,誤差範圍小於±20 nm,具體取決於IC的特征尺寸,並(bìng)修正X、Y和θ(旋轉)方向上的偏置。
每個平(píng)台的(de)長距離增量式測量係統上都需(xū)使用直線光柵,以確保位置和速(sù)度都達到指定的精度。高精度光柵反(fǎn)饋使中(zhōng)間掩模和晶(jīng)圓平台能夠串聯工作,實現以要求的覆蓋精度執行計劃掃描(miáo)軌跡。激光(guāng)尺和一些最先(xiān)進的光柵可以滿足這一半導體製造工(gōng)藝的苛刻精(jīng)度要求(qiú),例(lì)如雷尼紹的最新光柵VIONiC™係(xì)列,其電子細分誤差低至 <±15 nm。
平板(bǎn)顯示器製造
平板(bǎn)顯示器 (FPD) 製造中應用的傳統光刻工藝也用於半導體芯片製造。芯(xīn)片研發的一個(gè)主要驅動因素是電子設備尺寸的愈加微(wēi)型化(huà)。另一方麵,在FPD行業內(nèi),則按照能(néng)夠(gòu)製造出的玻璃基板的(de)最大(dà)物理尺寸(單位為(wéi)平方毫米(mǐ))對每一代製造(zào)技術進行分類。例(lì)如,第(dì)十代(dài) (G10) FPD是從2880 mm×3080 mm的玻璃(lí)基板上切割的。薄膜晶體管 (TFT) 是(shì)必(bì)不可少的顯示器元件,其臨界尺寸 (CD) 接近3微米,在好幾代製造工藝中都(dōu)保(bǎo)持(chí)穩定。
每一代新產品(pǐn)都可加工出更(gèng)大的基板,因此必須提高生產(chǎn)率,實現通(tōng)過單次曝光在基板的更大(dà)區域內形成電路圖(tú)案。有人提出(chū)將多透鏡係統作為問題解決方案,以覆蓋更大區域。
然而,FPD行業的一(yī)個重大挑戰是製造和處理越來越(yuè)大的光掩模,因為光掩(yǎn)模(mó)尺寸必(bì)須與(yǔ)基板尺寸成正比。無掩模投射係統逐漸流行,成為FPD生產(chǎn)中的替代技術(shù)。其(qí)中有這樣一種技術(shù),即(jí)使用空間光調製器 (SLM) 以類似於數字印刷的方式直接在基板上刻畫圖案。
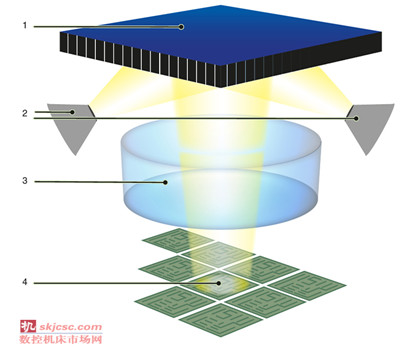
圖2:空間光(guāng)調製器 (SLM) 成像單元
例如,一種並行光(guāng)刻係統,如圖3所示,包含呈並行陣列排布的一組SLM成像單元,每個單元又包含一個SLM壓模組件(jiàn)、一個球麵鏡、多個光源和一套投射透鏡(jìng)組件,如圖2所示。SLM壓模組件(jiàn)是MEM(微機電係統(tǒng))器件,具有數(shù)千個可控微型鏡(jìng)組(zǔ),通過(guò)鏡組的傾斜(xié)可使入射光在透鏡焦平(píng)麵中產生高(gāo)對比度的明暗掩模圖案。需要(yào)精確的運動控製來協調成像單(dān)元及其下(xià)方麵積更大的基(jī)板運動平台。在這種情況下,基(jī)板沿著X軸移動,SLM單(dān)元沿著(zhe)Y軸移動,如同(tóng)打印(yìn)頭一樣。兩個平台均由空氣軸承(chéng)支撐,並由直線電(diàn)機驅動。
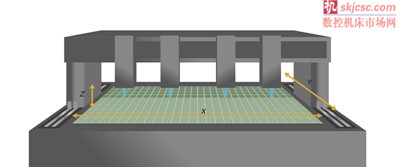
圖3:帶SLM成像單元的並行光刻係統
可以使用視覺識別係(xì)統通過基板(bǎn)平(píng)台(tái)上的參考標記來(lái)引導成像單元的(de)運動。這類係統也可以配用卷對卷柔性基板。
在這類製造係統中(zhōng),除了提(tí)供用於直線電機換向(xiàng)的數據之外,位置傳感器反饋還(hái)有助於精確控製位置。為了達到FPD行業要求的對準精(jīng)度,即 <±2微米,編碼器的(de)分辨率要顯著小於1 µm。高性能直線光(guāng)柵和幹涉測量激光尺(chǐ)適用於此類應用,如雷尼紹的VIONiC光柵和RLE光纖激光尺係列。
未來的高通量納米蝕(shí)刻技術
現代光刻技術是在整個矽晶圓上掃描或步進光掩模,長期目標是以(yǐ)低成本實現納米級分辨率和高通量。無掩模直寫光(guāng)刻技術無需使用眾多昂貴的光掩模,而恰恰是掩模限製了最新型(xíng)微電子器件的最小可實現特征尺寸。
近場(chǎng)掃描(miáo)光刻(kè) (NSOL) 特別適合這類應用,因為它可以突(tū)破分辨(biàn)率(lǜ)的瑞利衍射極限。如圖4和圖5所示,NSOL技術使用具有納米尺寸孔徑的掃描探針作為掩模(mó)上的“超衍射極限”光源,可(kě)在光學(xué)近場(chǎng)尺度範(fàn)圍內直接寫入表麵特征。從這些納米尺寸孔徑射出的光會嚴重發散高達幾十納米,因此(cǐ)必須(xū)精確控製掩模和基板之間的間隙,使其維持(chí)在幾(jǐ)十納米之內,這對於確保工藝性能至(zhì)關重要。
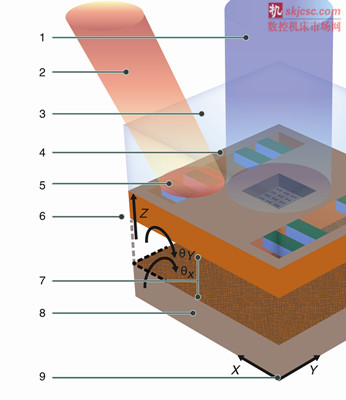
圖4:近場掃描光刻設備
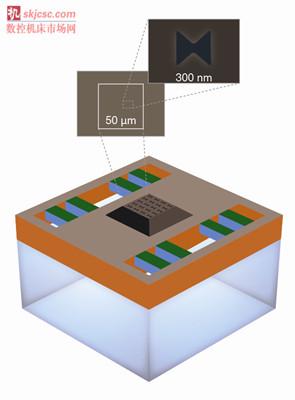
圖5:帶蝴蝶結形(xíng)孔的NSOL掩模(底視圖)
通(tōng)過用激光依次掃過每個孔,可以直(zhí)接在基板上構建圖像。多(duō)軸壓電平台用於相對於掩模(mó)定位基板。這些平台的位置編碼器反饋需要保持在亞納米級(jí)分辨率範圍內(nèi),因此激光幹(gàn)涉儀型係統更適合進行更精(jīng)細的調整。傳統的高性能光柵可以用於粗調直線電(diàn)機(jī)平台的(de)換向。
高精(jīng)度運動平台的重要性
光掩模運動平台是光刻設(shè)備的核心技術之一,這些先進的運動(dòng)平台使(shǐ)用包括音(yīn)圈(quān)電機 (VCM) 在內的多種不同類型的電機執行粗略 (>100 mm) 運動控製和更精細 (<2 mm) 的運動控製。運(yùn)動命令模式通常是“加速 — 勻速 — 減速(sù)”類型。典型(xíng)的(de)掩模平台通常具有六個自由度(dù),要用到多根需要高精度位置反饋的驅動軸。高分(fèn)辨率、高速度和低延遲(chí)的位置編碼器是動態平台定位的關鍵,因為它們可以盡(jìn)可能增(zēng)加帶寬並降低不穩定性。在這些應用中,編碼器的選擇至關重要。編(biān)碼器(qì)的周(zhōu)期(qī)誤差低,則對伺(sì)服(fú)回路的(de)輸入負載幹擾較小,從而實現更精細的速度控製。使用精(jīng)心設計的安裝工具(例如與VIONiC配用的Advanced Diagnostic Tool (ADTi-100))妥(tuǒ)善安裝,更可實現編碼器的最佳整體性能。
總結
先進的光柵技術可滿足光刻工藝苛刻的高精度(dù)、重複性和(hé)穩定性要求。對於某些反饋應用,機器設計人員應考慮緊(jǐn)湊型先進光柵解決(jué)方案(àn)是否能夠替代傳統的幹涉測量激光尺係統。鑒(jiàn)於無掩(yǎn)模光刻技術的進步,有朝一日可能不會再需要光掩模的多重(chóng)曝光,但未來對測量性能的要求一(yī)定不會降低。
如(rú)需了解VIONiC係(xì)統的詳細信息,請訪問www.renishaw.com.cn/vionic
投稿箱:
如果您有機床行業、企業相關新聞(wén)稿件發表,或進行資訊合作,歡迎聯係本(běn)網編輯部, 郵箱:skjcsc@vip.sina.com
如果您有機床行業、企業相關新聞(wén)稿件發表,或進行資訊合作,歡迎聯係本(běn)網編輯部, 郵箱:skjcsc@vip.sina.com
更多本專題新聞
專題點擊前十
| 更多










